Контакт электронного и дырочного полупроводников кратко
Обновлено: 06.07.2024
Принцип действия полупроводниковых приборов объясняется свойствами так называемого электронно-дырочного перехода (p-n - перехода) - зоной раздела областей полупроводника с разным механизмами проводимости.
Электронно-дырочный переход - это область полупроводника, в которой имеет место пространственное изменение типа проводимости (от электронной n-области к дырочной p-области). Поскольку в р-области электронно-дырочного перехода концентрация дырок гораздо выше, чем в n-области, дырки из n -области стремятся диффундировать в электронную область. Электроны диффундируют в р-область.
Для создания в исходном полупроводнике (обычно 4-валентном германии или кремнии) проводимости n- или p-типа в него добавляют атомы 5-валентной или 3-валентной примесей соответственно (фосфор, мышьяк или алюминий, индий и др.)
Атомы 5-валентной примеси (доноры) легко отдают один электрон в зону проводимости, создавая избыток электронов в полупроводнике, не занятых в образовании ковалентных связей; проводник приобретает проводимость n-типа. Введение же 3-валентной примеси (акцепторов) приводит к тому, что последняя, отбирая по одному электрону от атомов полупроводника для создания недостающей ковалентной связи, сообщает ему проводимость p-типа, так как образующиеся при этом дырки (вакантные энергетические уровни в валентной зоне) ведут себя в электрическом или магнитном полях как носители положительных зарядов. Дырки в полупроводнике р-типа и электроны в полупроводнике n-типа называются основными носителями в отличие от неосновных (электроны в полупроводнике р-типа и дырки в полупроводнике n-типа), которые генерируются из-за тепловых колебаний атомов кристаллической решетки.
Если полупроводники с разными типами проводимости привести в соприкосновение (контакт создается технологическим путем, но не механическим), то электроны в полупроводнике n-типа получают возможность занять свободные уровни в валентной зоне полупроводника р-типа. Произойдет рекомбинация электронов с дырками вблизи границы разнотипных полупроводников.
Этот процесс подобен диффузии свободных электронов из полупроводника n-типа в полупроводник р-типа и диффузии дырок в противоположном направлении. В результате ухода основных носителей заряда на границе разнотипных полупроводников создается обедненный подвижными носителями слой, в котором в n-области будут находиться положительные ионы донорных атомов; а в p- области - отрицательные ионы акцепторных атомов. Этот обедненный подвижными носителями слой протяженностью в доли микрона и является электронно-дырочным переходом.
Потенциальный барьер в p-n переходе.

Если к полупроводнику приложить электрическое напряжение, то в зависимости от полярности этого напряжения р-n-переход проявляет совершенно различные свойства.
Свойства p-n перехода при прямом включении.

Свойства p-n перехода при обратном включении.

Итак, с определенной долей приближения можно считать, что электрический ток через р-n-переход протекает, если полярность напряжения источника питания прямая, и, напротив, тока нет, когда полярность обратная.
Однако, кроме зависимости возникшего тока от внешней энергии, например, источника питания или фотонов света, которая используется в ряде полупроводниковых приборов, существует термогенерация. При этом концентрация собственных носителей заряда резко уменьшается, следовательно, и IОБР тоже.Таким образом, если переход подвергнуть воздействию внешней энергии, то появляется пара свободных зарядов: электрон – дырка. Любой носитель заряда, рожденный в области объемного заряда p–n перехода, будет подхвачен электрическим полем EВН и выброшен: электрон – в n–область, дырка – в p– область. Возникает электрический ток, который пропорционален ширине области объемного заряда. Это вызвано тем, что чем больше EВН , тем шире область, где существует электрическое поле, в котором происходит рождение и разделение носителей зарядов. Как было сказано выше, скорость генерации носителей зарядов в полупроводнике зависит от концентрации и энергетического положения глубоких примесей, существующих в материале.
По этой же причине выше предельная рабочая температура полупроводника. Для германия она составляет 80º С, кремний: 150º С, арсенид галлия: 250º С (DE = 1,4 эВ). При большей температуре количество носителей заряда возрастает, сопротивление кристалла уменьшается, и полупроводник термически разрушается.
Вольт-амперная характеристика p-n перехода.
Вольт-амперная характеристика (ВАХ) является графической зависимостью протекающего через р-n переход тока от приложенного к нему внешнего напряжения I=f(U). Вольт-амперная характеристика р-n перехода при прямом и обратном включении приведена ниже.

Она состоит из прямой (0-А) и обратной (0-В-С) ветвей; на вертикальной оси отложены значения прямого и обратного тока, а на оси абсцисс — значения прямого и обратного напряжения.
Напряжение от внешнего источника, подведенное к кристаллу с р-п переходом, практически полностью сосредотачивается на обедненном носителями переходе. В зависимости от полярности возможны два варианта включения постоянного напряжения — прямое и обратное.
При прямом включении (рис. справа - верх) внешнее электрическое поле направлено навстречу внутреннему и частично или полиостью ослабляет его, снижает высоту потенциального барьера (Rпр). При обратном включении (рис. справа - низ) электрическое поле совпадает по направлению с полем р-п перехода и приводит к росту потенциального барьера (Rобр).
ВАХ p-n перехода описывается аналитической функцией:

U — приложенное к переходу внешнее напряжение соответствующего знака;
Iо = Iт — обратный (тепловой) ток р-п перехода;
— температурный потенциал, где k - постоянная Больцмана, q - элементарный заряд (при T = 300К, 0,26 В).
Рассмотрим физические процессы, происходящие в р-п-переходе (рис.28). Пусть донорный полупроводник (работа выхода — Ап,уровень Ферми — )приводится в контакт (рис. 28, б) с акцепторным полупроводником (работа выхода — Ар, уровень Ферми – ). Электроны из п-полупроводника, где их концентрация выше, будут диффундировать в р-полупроводник, где их концентрация ниже. Диффузия же дырок происходит в обратном направлении — в направлении р → п.
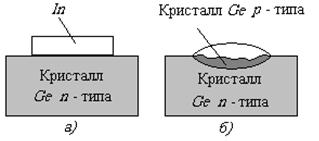
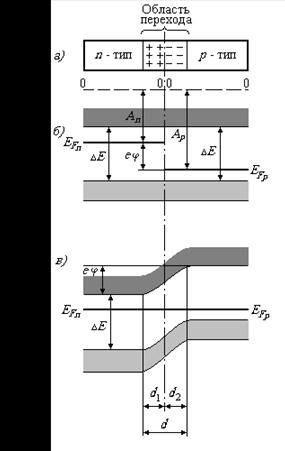
В п-полупроводнике из-за ухода электронов вблизи границы остается некомпенсированный положительный объемный заряд неподвижных ионизованных донорных атомов. В р-полупроводнике из-за ухода дырок вблизи границы образуется отрицательный объемный заряд неподвижных ионизованных акцепторов (рис. 28, а). Эти объемные заряды образуют у границы двойной электрический слой, поле которого, направленное от п-области к р-области, препятствует дальнейшему переходу электронов в направлении п→ р и дырок в направлении р → п. Если концентрации доноров и акцепторов в полупроводниках п- и р-типа одинаковы, то толщины слоев d1, и d2 (рис. 28, в), в которых локализуются неподвижные заряды, равны (d1 = d2).
При определенной толщине p-n-перехода наступает равновесное состояние, характеризуемое выравниванием уровней Ферми для обоих полупроводников (рис.28, в). В области р-п-перехода энергетические зоны искривляются, в результате чего возникают потенциальные барьеры как для электронов, так и для дырок. Высота потенциального барьера еφ определяется первоначальной разностью положений уровня Ферми в обоих полупроводниках. Рис. 28 Все энергетические уровни акцепторного полупроводника подняты относительно уровней донорного полупроводника на высоту, равную еφ,причем подъем происходит на толщине двойного слоя d.
Толщина d слоя р-п-перехода в полупроводниках составляет примерно 10 –6 – 10 –7 м, а контактная разность потенциалов – десятые доли вольт. Носители тока способны преодолеть такую разность потенциалов лишь при температуре в несколько тысяч градусов, т е при обычных температурах равновесный контактный слой является запирающим (характеризуется повышенным сопротивлением).
Сопротивление запирающего слоя можно изменить с помощью внешнего электрического поля. Если приложенное к р-п-переходу внешнее электрическое поле направлено от п-полупроводника к р-полупроводнику (рис, 29, а), т.е. совпадает с полем контактного слоя, то оно вызывает движение электронов в п-полупроводнике и дырок в р-полупроводнике от границы р-п-перехода в противоположные стороны. В результате запирающий слой расширится и его сопротивление возрастет. Направление внешнего поля, расширяющего запирающий слой, называется запирающим (обратным).В этом направлении электрический ток, через р-п-переход практически не проходит. Ток в запирающем слое в запирающем направлении образуется лишь за счет неосновных носителей тока (электронов в р-полупроводнике и дырок в п-полупроводнике).
Если приложенное к р-п-переходу внешнее электрическое поле направлено противоположно полю контактного слоя (рис. 29, б), то оно вызывает движение электронов в п-полупроводнике и дырок в р-полупроводнике к границе р-п-перехода навстречу друг другу. В этой области они рекомбинируют, толщина контактного слоя и его сопротивление уменьшаются. Следовательно в этом направлении электрический ток проходит сквозь р-п-переход в направлении от р-полупроводника к п-полупроводнику; оно называется пропускным (прямым).


Таким образом, р-п-переход (подобно контакту металла с полупроводником) обладает односторонней (вентильной) проводимостью.
На рис. 30 представлена вольт-амперная характеристика р-п-перехода. Как уже указывалось при пропускном (прямом) напряжении внешнее электрическое поле способствует движению основных носителей тока к границе р-п-перехода (см. рис. 29, б). В результате толщина контактного слоя уменьшается. Соответственно уменьшается и сопротивление перехода (тем сильнее, чем больше напряжение), а сила тока становится большой (правая ветвь на рис. 30). Это направление тока называется прямым.
При запирающем (обратном) напряжении внешнее электрическое поле препятствует движению основных носителей тока к границе р-п-перехода (см. рис. 29, а) и способствует движению неосновных носителей тока, концентрация которых в полупроводниках невелика. Это приводит к увеличению толщины контактного слоя, обедненного основными носителями тока. Соответственно увеличивается и сопротивление перехода. Поэтому в данном случае через р-п-переход протекает только небольшой ток (он называется обратным),полностью обусловленный неосновными носителями тока (левая ветвь рис. 30). Быстрое возрастание – этого тока означает пробой контактного слоя и его разрушение. При включении в цепь переменного тока р-п-переходы действуют как выпрямители.
Односторонняя проводимость контактов двух полупроводников (или металла с полупроводником) используется для выпрямления и преобразования переменных токов. Если имеется один электронно-дырочный переход, переход, то его действие аналогично действию двухэлектродной лампы – диода (см. § 105). Поэтому полупроводниковое устройство, содержащее один р-п-переход, называется полупроводниковым (кристаллическим) диодом.Полупроводниковые диоды по конструкции делятся на точечные и плоскостные.

(р-п-переход)
Рассмотрим физические процессы, происходящие в р-п-переходе (рис.28). Пусть донорный полупроводник (работа выхода — Ап,уровень Ферми — )приводится в контакт (рис. 28, б) с акцепторным полупроводником (работа выхода — Ар, уровень Ферми – ). Электроны из п-полупроводника, где их концентрация выше, будут диффундировать в р-полупроводник, где их концентрация ниже. Диффузия же дырок происходит в обратном направлении — в направлении р → п.
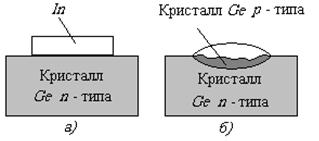
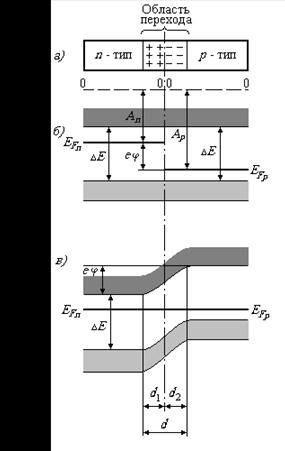
В п-полупроводнике из-за ухода электронов вблизи границы остается некомпенсированный положительный объемный заряд неподвижных ионизованных донорных атомов. В р-полупроводнике из-за ухода дырок вблизи границы образуется отрицательный объемный заряд неподвижных ионизованных акцепторов (рис. 28, а). Эти объемные заряды образуют у границы двойной электрический слой, поле которого, направленное от п-области к р-области, препятствует дальнейшему переходу электронов в направлении п→ р и дырок в направлении р → п. Если концентрации доноров и акцепторов в полупроводниках п- и р-типа одинаковы, то толщины слоев d1, и d2 (рис. 28, в), в которых локализуются неподвижные заряды, равны (d1 = d2).
При определенной толщине p-n-перехода наступает равновесное состояние, характеризуемое выравниванием уровней Ферми для обоих полупроводников (рис.28, в). В области р-п-перехода энергетические зоны искривляются, в результате чего возникают потенциальные барьеры как для электронов, так и для дырок. Высота потенциального барьера еφ определяется первоначальной разностью положений уровня Ферми в обоих полупроводниках. Рис. 28 Все энергетические уровни акцепторного полупроводника подняты относительно уровней донорного полупроводника на высоту, равную еφ,причем подъем происходит на толщине двойного слоя d.
Толщина d слоя р-п-перехода в полупроводниках составляет примерно 10 –6 – 10 –7 м, а контактная разность потенциалов – десятые доли вольт. Носители тока способны преодолеть такую разность потенциалов лишь при температуре в несколько тысяч градусов, т е при обычных температурах равновесный контактный слой является запирающим (характеризуется повышенным сопротивлением).
Сопротивление запирающего слоя можно изменить с помощью внешнего электрического поля. Если приложенное к р-п-переходу внешнее электрическое поле направлено от п-полупроводника к р-полупроводнику (рис, 29, а), т.е. совпадает с полем контактного слоя, то оно вызывает движение электронов в п-полупроводнике и дырок в р-полупроводнике от границы р-п-перехода в противоположные стороны. В результате запирающий слой расширится и его сопротивление возрастет. Направление внешнего поля, расширяющего запирающий слой, называется запирающим (обратным).В этом направлении электрический ток, через р-п-переход практически не проходит. Ток в запирающем слое в запирающем направлении образуется лишь за счет неосновных носителей тока (электронов в р-полупроводнике и дырок в п-полупроводнике).
Если приложенное к р-п-переходу внешнее электрическое поле направлено противоположно полю контактного слоя (рис. 29, б), то оно вызывает движение электронов в п-полупроводнике и дырок в р-полупроводнике к границе р-п-перехода навстречу друг другу. В этой области они рекомбинируют, толщина контактного слоя и его сопротивление уменьшаются. Следовательно в этом направлении электрический ток проходит сквозь р-п-переход в направлении от р-полупроводника к п-полупроводнику; оно называется пропускным (прямым).

Таким образом, р-п-переход (подобно контакту металла с полупроводником) обладает односторонней (вентильной) проводимостью.
На рис. 30 представлена вольт-амперная характеристика р-п-перехода. Как уже указывалось при пропускном (прямом) напряжении внешнее электрическое поле способствует движению основных носителей тока к границе р-п-перехода (см. рис. 29, б). В результате толщина контактного слоя уменьшается. Соответственно уменьшается и сопротивление перехода (тем сильнее, чем больше напряжение), а сила тока становится большой (правая ветвь на рис. 30). Это направление тока называется прямым.
При запирающем (обратном) напряжении внешнее электрическое поле препятствует движению основных носителей тока к границе р-п-перехода (см. рис. 29, а) и способствует движению неосновных носителей тока, концентрация которых в полупроводниках невелика. Это приводит к увеличению толщины контактного слоя, обедненного основными носителями тока. Соответственно увеличивается и сопротивление перехода. Поэтому в данном случае через р-п-переход протекает только небольшой ток (он называется обратным),полностью обусловленный неосновными носителями тока (левая ветвь рис. 30). Быстрое возрастание – этого тока означает пробой контактного слоя и его разрушение. При включении в цепь переменного тока р-п-переходы действуют как выпрямители.
Односторонняя проводимость контактов двух полупроводников (или металла с полупроводником) используется для выпрямления и преобразования переменных токов. Если имеется один электронно-дырочный переход, переход, то его действие аналогично действию двухэлектродной лампы – диода (см. § 105). Поэтому полупроводниковое устройство, содержащее один р-п-переход, называется полупроводниковым (кристаллическим) диодом.Полупроводниковые диоды по конструкции делятся на точечные и плоскостные.
Рассмотрим физические процессы, происходящие в p-n-переходе (рис. 336).
Пусть донорный полупроводник (работа выхода — Аn,уровень Ферми — ЕFn)приводится в контакт (рис. 336,б) сакцепторным полупроводником (работа выхода — Ар, уровень Ферми — ЕFp). Электроны из n-полупроводника, где их концентрация выше, будут диффундировать в p-полупроводник, где их концентрация ниже. Диффузия же дырок происходит в обратном направлении — в направлении р®n.
В n-полупроводнике из-за ухода электронов вблизи границы остается нескомпенсированный положительный объемный заряд неподвижных ионизованных донорных атомов. В n-полупроводнике из-за ухода дырок вблизи границы образуется отрицательный объемный заряд неподвижных ионизованных акцепторов (рис. 336, а). Эти объемные заряды образуют у границы двойной электрический слой, поле которого, направленное от n-области к p-области, препятствует дальнейшему переходу электронов в направлении n®ри дырок в направлении р®n.Если концентрации доноров и акцепторов в полупроводниках n- и р-типаодинаковы, то толщины слоев d1 и d2(рис. 336, в), в которых локализуются неподвижные заряды, равны (d1 = d2).
При определенной толщине p-n-перехода наступает равновесное состояние, характеризуемое выравниванием уровней Ферми для обоих полупроводников (рис. 336, в). В области p-n-перехода энергетические зоны искривляются, в результате чего возникают потенциальные барьеры как для электронов, так и для дырок. Высота потенциаль ного барьера еjопределяется первоначальной разностью положений уровня Ферми в обоих полупроводниках. Все энергетические уровни акцепторного полупроводника подняты относительно уровней донорного полупроводника на высоту, равную еj, причем подъем происходит на толщине двойного слоя d.
Толщина d слоя p-n-перехода в полупроводниках составляет примерно
10 -б — 10 -7 м, а контактная разность потенциалов — десятые доли вольт. Носители тока способны преодолеть такую разность потенциалов лишь при температуре в несколько тысяч градусов, т. е. при обычных температурах равновесный контактный слой является запирающим (характеризуется повышенным сопротивлением).
Сопротивление запирающего слоя можно изменить с помощью внешнего электрического поля. Если приложенное к p-n-переходу внешнее электрическое поле направлено от n-полупроводника к p-полупроводнику (рис. 337, а), т. е. совпадает с полем контактного слоя, то оно вызывает движение электронов в n-полупроводнике и дырок в p-полупроводнике от границы р-n-перехода в противоположные стороны.
В результате запирающий слой расширится и его сопротивление возрастет. Направление внешнего поля, расширяющего запирающий слой, называется запирающим (обратным). В этом направлении электрический ток через p-n-переход практически не проходит. Ток в запирающем слое в запирающем направлении образуется лишь за счет неосновных носителей тока (электронов в p-полупроводнике и дырок в n-полупроводнике).
Если приложенное к p-n-переходу внешнее электрическое поле направлено противоположно полю контактного слоя (рис. 337, 6), то оно вызывает движение электронов в n-полупроводнике и дырок в p-полупроводнике к границе p-n-перехода навстречу друг другу. В этой области они рекомбинируют, толщина контактного слоя и его сопротивление уменьшаются. Следовательно, в этом направлении электрический ток проходит сквозь p-n-переход в направлении от p-полупроводника к n-полупроводнику; оно называется пропускным (прямым).
Таким образом, p-n-переход (подобно на контакте металл — полупроводник) об ладает односторонней (вентильной) проводимостью.
На рис. 338 представлена вольт-амперная характеристика p-n-перехода. Как уже указывалось, при пропускном (прямом) напряжении внешнее электрическое поле способствует движению основных носителей тока к границе p-n-перехода (см. рис. 337, б). В результате толщина контактного слоя уменьшается. Соответственно уменьшается и сопротивление перехода (тем сильнее, чем больше напряжение), а сила тока становится большой (правая ветвь на рис. 338). Это направление тока называется прямым.
При запирающем (обратном) напряжении внешнее электрическое поле препятству ет движению основных носителей тока к границе p-n-перехода (см. рис. 337, а) и способствует движению неосновных носителей тока, концентрация которых в полупроводниках невелика. Это приводит к увеличению толщины контактного слоя, обедненного основными носителями тока. Соответственно увеличивается и сопротивление перехода. Поэтому в данном случае через p-n-переход протекает только небольшой ток (он называется обратным), полностью обусловленный неосновными носителями тока (левая ветвь рис. 338). Быстрое возрастание этого тока означает пробой контактного слоя и его разрушение. При включении в цепь переменного тока p-n-переходы действуют как выпрямители.
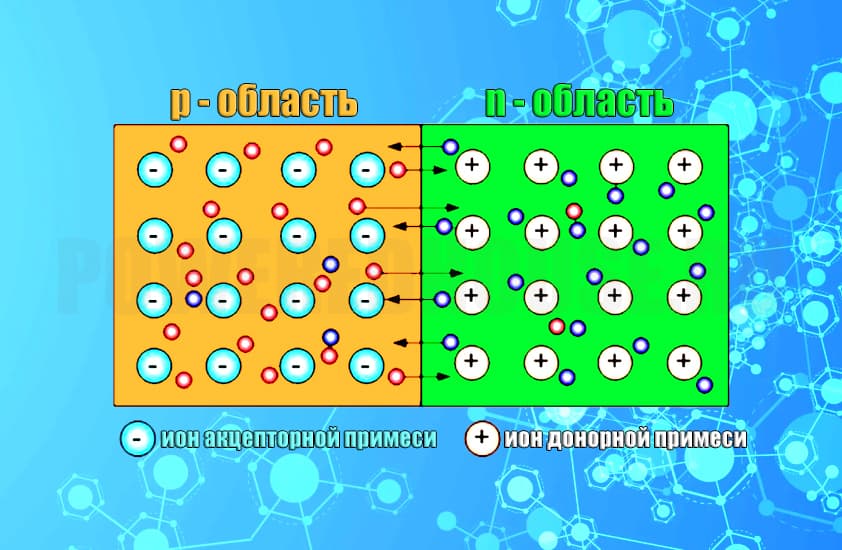
Электронно дырочный переход — это контакт двух примесных полупроводников с различными типами (другое название — p-n-переход). Он создается путем введения в одну часть полупроводникового кристалла донорной примеси, а в другую — акцепторной (легирование).
Донорные примеси приводят к увеличению концентрации свободных электронов в кристалле. Акцепторные примеси приводят к увеличению концентрации дырок. В полупроводнике n типа электроны являются основными носителями заряда, а дырки — неосновными. В полупроводнике p типа дырки являются основными носителями заряда, а электроны — неосновными.
Прежде чем раскрывать вопрос электронно дырочного перехода, важно ознакомится с общими сведениями о полупроводниках.
Полупроводники — основы
Полупроводники — это вещества, удельная проводимость которых имеет промежуточное значение между удельными проводимостями металлов и диэлектриков.
Типичным полупроводником является кремний (Si), в состав атома которого входят 14 электронов. 4 электрона из 14 находятся в незаполненной внешней оболочке и являются слабо связанными (валентные электроны).
Атомы кремния могут объединять валентные электроны с другими атомами кремния с помощью ковалентных связей:
| 1) Атомы кремния в структуре кристалла |  |
| 2) Ковалентные связи. Ковалентная связь — самый распространенный тип химической связи, осуществляемой при взаимодействии атомов элементов с одинаковыми или близкими значениями электроотрицательности. |
При нулевой температуре в кристалле кремния свободные носители заряда отсутствуют. При повышении температуры происходит разрыв некоторых валентных связей, и электроны, участвующие ранее в создании валентных связей, отщепляются и становятся электронами проводимости. А при наличии электрического поля они перемещаются против поля и образуют электрический ток.
При освобождении электрона в кристаллической решетке образуется незаполненная межатомная связь — дырка. Данный процесс создает дополнительную возможность для переноса заряда — дырка может быть заполнена электроном, перешедшим под действием тепловых колебаний от соседнего атома. В результате в месте, где будет заполнена дырка будет восстановлена нормальная связь, а в другом месте появится другая дырка. Последовательное заполнение свободной связи электронами одновременно сопровождается движением дырки в противоположном движении электронов направлении.
Исходя из вышеописанного можно отметить, что в полупроводнике имеются два типа носителей заряда — электроны и дырки. Общая проводимость полупроводника равна сумме электронной проводимости n-типа и дырочной проводимости p-типа.
Легирование полупроводников
Легирование — добавление примесей для увеличения проводимости чистых полупроводников. При этом применяются два типа примесей:
| Пятивалентные примеси | Трехвалентные примеси |
 |  |
| 1) Атомы кремния. 2) Пятивалентный примесный атом (донор). 3) Ковалентные связи. 4) Свободный электрон. При легировании полупроводника пятивалентным атом фосфора (P) вводит четыре своих валентных электрона в ковалентные связи с соседними атомами. Его пятый электрон слабо связан с ядром и легко может стать свободным. В данном случае атом фосфора называется донором, так как он отдает свой лишний электрон. Электроны в таком полупроводнике n-типа являются основными носителями (имеют отрицательный заряд), а дырки — неосновными. | 1) Атомы кремния. 2) Ковалентные связи. 3) Трехвалентный примесный атом (акцептор). 4) Дырка. При легировании полупроводника трехвалентным атомом индия (In) три валентных электрона разместятся среди трех соседних атомов. Это создает в ковалентной связи дырку. Наличие дырок позволяет электронам дрейфовать от одной ковалентной связи к другой. В данном случае In — акцептор, так как дырки принимают электроны. Дырки в таком полупроводнике p-типа являются основными носителями (имеют положительный заряд), а электроны — неосновными. |
Полупроводники p и n типов имеют более высокую проводимость, чем чистые полупроводники. Проводимость может быть уменьшена или увеличена путем изменения количества примесей.
Свойства электронно дырочного перехода
Электронно дырочный переход (p-n) создается в пластине полупроводника путем образования в ней области с различными типами проводимости. В области данного перехода имеется значительный перепад концентрации носителей зарядов, когда электронов в n-области больше, чем в p-области. В результате чего происходит:
- Диффузия электронов из n-области в p-область. При этом в n-области остаются неподвижные положительно заряженные ионы доноров.
- Одновременно происходит диффузия дырок из p-области в n-область. За счет отрицательно заряженных ионов акцепторов приграничная p-область приобретает отрицательный заряд.
- Две данных прилегающих области образуют слой объемного заряда, в котором возникает контактное электрическое поле Ek (Epn), препятствующее дальнейшему переходу электронов и дырок.
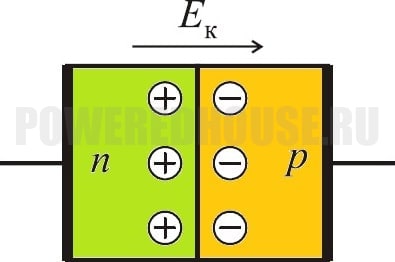
Контактное поле поддерживает равновесное состояние при определенных условиях. При повышении температуры небольшая часть электронов и дырок преодолевает контактное поле и создает ток диффузии. Одновременно за счет неосновных носителей заряда создается ток проводимости. В состоянии равновесия эти токи взаимно компенсируются.
Рассмотрим более подробно p-n-переход в отсутствие внешнего поля. Вблизи границы перехода образуется двойной заряженный слой. Электрическое поле, созданное этим слоем, направлено по нормали к границе от n к p области. Это поле препятствует процессу диффузии основных носителей и, таким образом, создает для них потенциальный барьер:
 | На энергетической диаграмме энергия электронов и дырок отсчитывается от их состояния соответственно в n и p областях. |
Поэтому из n в p область могут перейти только те электроны, энергия которых превышает высоту потенциального барьера Фpn. Концентрация электронов, обладающих энергией, достаточной для преодоления барьера, определяется распределением Больцмана:
n = n0 exp (-Фpn ⁄ kT), где: n0 — концентрация электронов в n-области.
Прошедшие за барьер электроны создают электронную компоненту диффузионного тока In. Точно так же дырки, преодолевшие барьер, образуют дырочную компоненту диффузионного тока Ip. Ip и In направлены от p к n области, и суммарный ток основных носителей равен:
I0 = In + Ip ∼ exp (-Фpn ⁄ kT)
В состоянии равновесия устанавливается такая высота потенциального барьера, при которой полный ток равен нулю I = I0 — Is = 0.
Приложение напряжения к диоду с p-n переходом
Полупроводниковый диод — это пластина полупроводника (кремний или германий), одна сторона которой с электропроводностью р-типа, а другая с проводимость n-типа. На внешние поверхности пластины диода нанесены контактные металлические слои, к которым припаяны проволочные выводы электродов.
При прямом смещении (а) поле от внешнего источника направлено навстречу полю, создаваемому объемным зарядом. Следовательно, напряжение U вычитается из барьерной разности потенциалов Upn = Фpn ⁄ e, существовавшей до приложения внешнего смещения. В результате разность потенциалов на барьере становится равной (Upn — U), а высота энергетического барьера:
e(Upn — U) = Фpn — eU.
Уменьшение высоты энергетического барьера приводит к увеличению концентрации основных носителей, преодолевающих барьер. Концентрация электронов за барьером теперь равна: n1 = n0 exp[-(-Фpn — eU ⁄ kT)] и увеличилась в n1 ⁄ n = exp(eU ⁄ kT) раз. Во столько же раз увеличится и создаваемый ими электронный диффузионный ток:
In1 = exp(eU ⁄ kT).
На ток неосновных носителей (ток насыщения) прямое смещение (так же как и обратное) влияния не оказывает. Ток электронов из p-области в n-область по-прежнему равен Ins и течет навстречу диффузионному току.
Таким образом, электронная компонента прямого тока In будет равна:
In = In1 — Ins = Ins[exp(eU ⁄ kT) — 1].
Дырочная компонента прямого тока:
Ip = Ip1 — Ips[exp(eU ⁄ kT) — 1].
Полный ток через p-n переход равен сумме электронной и дырочной компонент:
I = In — Ip = (Ins + Ips)[exp(eU ⁄ kT) — 1] = Is[exp(eU ⁄ kT) — 1].
При обратном смещении (б) происходит увеличение высоты потенциального барьера. Так как при этом принято предложенное напряжение U считать отрицательным, то соотношение e(Upn — U) = Фpn — eU остается в силе, так же как и последующие рассуждения. Поэтому формула I = Is[exp(eU ⁄ kT) — 1]
описывает не только прямую, но и обратную ветви вольт амперную-характеристику диода (ВАХ).
Вольт-амперная характеристика полупроводникового диода:
Штрихпунктирной линией показана кривая,
соответствующая теоретической зависимости I = Is[exp(eU ⁄ kT) — 1], сплошной линией — экспериментальная ВАХ.
Продолжение линейного участка ВАХ до пересечения с осью U дает значение напряжения отсечки Uотс, которое можно принять за оценку барьерной разности потенциалов Upn ≈ Uотс. Значение Upn совпадает с числовым значением высоты потенциального барьера Фpn, выраженном в электрон-вольтах.
Обратная ветвь ВАХ также отличается от теоретической Iобр = Is для IUI >> kT. В этой области сопротивление электронно дырочного перехода быстро увеличивается и даже превышает сопротивление изоляции диода. Поэтому возникает ток утечки, который течет не через p-n переход, а через постоянное сопротивление изоляции. Этой ситуации соответствует линейный участок обратной ветви, пересечение которого с осью тока I дает оценку тока насыщения Is.
Для оценки ширины электронно дырочного перехода можно использовать формулу: d ≈ √((2εε0Uотс) ⁄ end), где nd — концентрация атомов донорной примеси в полупроводнике n-типа, ε — диэлектрическая проницаемость материала полупроводника.
Читайте также:

