Резонансно туннельный диод реферат
Обновлено: 02.07.2024
Резонансно-туннельный диод можно создать на основе двухбарьерной квантово-размерной структуры (ДБКС, см. рис. 12.6). Такие приборы способны работать на частотах свыше 100 ГГц и обладают задержкой распространения сигнала менее пикосекунды. Теоретические расчёты прогнозируют рабочие частоты в 1 - 3 ТГц .
Рисунок 12.6 - Прохождение электронов через ДБКС (а) и структура со встроенными спейсерами (б)
Спейсеры вводятся для уменьшения рассеяния на примесях, согласования параметров решётки слоев и увеличения скорости движения носителей заряда через область обеднения. Принцип работы прибора заключается в следующем. С уменьшением разности E F – Е 0 приложенным внешним напряжением V резонансный поток электронов на уровень Е 0 выходит на насыщение, а затем резко прекращается. Это происходит в тот момент, когда Е 0 сравнивается с Е С , поскольку ниже дна зоны проводимости
электроны отсутствуют. Резкий срыв тока ДБКС до нуля соответствует высокой отрицательной дифференциальной проводимости.
Отметим, что такая диодная структура может быть включена и по триодной схеме, поскольку смещение на каждый барьер можно подавать независимо.
ДБКС находят различное применение в активных элементах. Она может являться как базой, эмиттером, коллектором для биполярного транзистора, так и затвором, стоком, истоком и даже каналом полевого гетеротранзистора. Во всех этих применениях ДБКС придаёт новые свойства транзисторам и значительно расширяет их функциональные возможности.
Рисунок 12.7 - Структура (а) и схема соединения элементов (б) монолитного гибридного прибора с резонансно-туннельным диодом и транзистором с барьером Шоттки
Примером может служить монолитный гибридный прибор, объединяющий резонансно-туннельный диод и полевой гетеротранзистор (см. рис. 12.7). Выходные ВАХ такого прибора имеют участок
отрицательного дифференциального сопротивления. Основное применение приборов подобного типа - цифровые быстродействующие ИС.
Другим примером использования ДБСК является транзистор на горячих электронах с резонансным туннелированием - ТГЭРТ (RHET, см. рис. 12.8). Принцип работы такого прибора легко понять из рисунка 12.9, где показана энергетическая диаграмма ТГЭРТ, включённого с общим эмиттером; E 1 - резонансное состояние в квантовой яме. Если напряжение база-эмиттер равно нулю, то инжекция электронов отсутствует и коллекторный ток так же равен нулю (рисунок 12.9, а). Когда же напряжение база-эмиттер становится приблизительно равно 2E 1 /q (рисунок 12.9, б), электроны начинают инжектироваться в базу, резонансно-туннелируя через квантовую яму, баллистически (или квазибаллистически) пролетают базу и проходят над коллекторным барьером, к которому приложено положительное напряжение. Возникает коллекторный ток. По достижении определенного смещения база-эмиттер (рисунок 12.9, в) коллекторный ток резко падает, так как перестают соблюдаться условия резонансного туннелирования.
Рисунок 12.8 - Структура и зонная диаграмма ТГЭРТ
Рисунок 12.9 - Энергетическая диаграмма ТГЭРТ при трёх значениях напряжения база - эмиттер
Рисунок 12.10 – Вертикальный резонансно-туннельный транзистор
На работе резонансно-туннельных транзисторов, к сожалению, отрицательно сказывается наличие неконтролируемых примесей и дефектов в области квантовой точки и туннельных барьеров. Различное положение примесных атомов в области квантовой точки для разных транзисторов приводит из-за искажений локального потенциала к значительному разбросу характеристик. Кроме того, через электронные атомные уровни примеси тоже может происходить резонансное туннелирование, - ВАХ транзистора будет иметь в этом случае пики, положение которых не зависит от напряжения на затворе. Однако резонансно-туннельные транзисторы потребляют очень малую мощность на одно переключение, - в этом их преимущество.
Особо нужно подчеркнуть, что последние два типа элементов сохраняют указанные характеристики и при комнатной температуре. Именно этот факт в сочетании с их высоким быстродействием привёл к конструированию высокоскоростных ИС нового поколения для вычислительной техники.
Туннелирование электронов в низкоразмерной структуре определяется не только характеристиками составляющих её потенциальных барьеров,но и разрешенными энергетическими состояниями для электронов внутри самой структуры
Содержание
1. Резонансное туннелирование 2
2. Приборы на резонансном туннелировании 4
2.1 Диоды на резонансном туннелировании 4
2.2 Транзисторы на резонансном туннелировании 8
2.3 Логические элементы на резонансно-туннельных
приборах 10
Заключение
Вложенные файлы: 1 файл
Реферат 3 курс.docx
- Резонансное туннелирование 2
- Приборы на резонансном туннелировании 4
2.1 Диоды на резонансном туннелировании 4
2.2 Транзисторы на резонансном туннелировании 8
2.3 Логические элементы на резонансно-туннельных
Туннелирование электронов в низкоразмерной структуре определяется не только характеристиками составляющих её потенциальных барьеров,но и разрешенными энергетическими состояниями для электронов внутри самой структуры. В низкоразмерной структуре, ограниченной двумя потенциальными барьерами, имеет место резкое возростание протекающего через неё туннельного тока при совпадении уровня Ферми в инжектирующем электроде и дискретного уровня в низкоразмерной структуре. Это явление получило название резонансное туннелирование (resonant tunneling).Типичными структурами для наблюдения этого эффекта являются квантовые колодцы. Квантовый колодец — это квантовомеханическое явление, при котором активный слой лазера становится дном потенциальной ямы. Квантовый колодец возникает в полупроводниковых лазерах с двойной гетероструктурой и очень тонким активным слоем (толщиной в несколько сотен ангстрем, например 0,02 мкм). Лазеры этого типа делятся на лазеры с одиночным квантовым колодцем и лазеры с мультиквантовым колодцем. Возможности резонансного туннелирования через них были предсказаны Д.Бомом. Однако экспериментальное подтверждение было получено лишь более двух десятилетий спустя, после того как технология формирования сверхрешеток позволила создавать структуры с высококачественными квантовыми колодцами. Энергетическая диаграмма такой структуры и ее вольт-амперная характеристика показанная на рисунке 1.
Рисунок 1-Энергетическая диаграмма и вольт-амперная характеристика двух барьерной структуры с квантовым колодцем
2. Приборы на резонансном туннелировании
Явление резонансного туннелирования позволяет создавать диоды и тр анзисторы, работающие с временами переключения, составляющими единицы и десятые доли пс, то есть в диапазоне частот вплоть до нескольких ТГц (10 12 Гц).
2.1. Диоды на резонансном туннелировании
В общем случае резонансно-туннельный диод (resonant tunneling diode-RTD) представляет собой периодическую структуру, которая состоит из последовательно расположенных квантовых колодцев, разделенных потенциальными барьерами, с электрическими контактами к двум крайним противоположным областям. Чаще всего это двухбарьерные структуры с одним квантовым колодцем и симметричными характеристиками барьеров, поскольку по мере увеличения количества колодцев все труднее реализовать условия для согласованного резонансного переноса носителей заряда. Условное обозначение, эквивалентная схема такого диода и общий вид его основных электрических характеристик показаны на рисунке 2.
Рисунок 2-Условное обозначение резонансно-туннельного диода (а), его эквивалентная схема (б), вольт-амперная и вольт-фарадная характеристики (в)
Эквивалентная схема резонансно-туннельного диода включает в себя источник тока I(V) и емкость C(V), управляемые напряжением, и последовательное сопротивление Rs. Здесь параллельная цепочка из I(V) и C(V) представляет собой собственно диод, a Rs является суммой последовательных сопротивлений, таких как контактные сопротивления. Емкость C(V) является чрезвычайно важной при определении быстродействия прибора. За исключением области напряжений вблизи токового резонанса она приблизительно равна емкости, рассчитанной для нелегированного разделительного слоя и обедненного слоя прибора. Пик емкости в области отрицательного дифференциального сопротивления обусловлен резонансными электронами, накопленными в яме. Это должно приниматься во внимание при строгом обсуждении быстродействия. Отметим также, что I(V) и C(V) не зависят от частоты вплоть до предельных рабочих частот диода.
Основной особенностью резонансно-туннельных диодов является наличие на его вольт-амперной характеристике области отрицательного дифференциального сопротивления, которая является основой для большинства его практических применений. Наиболее важные электрические параметры: пиковое значение плотности тока (peak current density>) и пиковое напряжение (peak voltage) - напряжение в области пика плотности тока, долинная плотность тока в минимуме (valley current density), отношение этих плотностей тока (peak-to-valley ratio).
Пиковая плотность тока уменьшается экспоненциально с увеличением толщины барьера. Абсолютная величина пиковой плотности тока, полученная моделированием, хорошо согласуется с экспериментальными данными, в то время как расчетная величина долинной плотности тока оказывается на один-два порядка меньше экспериментальных значений.
Отношение токов в максимуме и минимуме для реальных приборов варьируется от единиц до нескольких десятков при комнатной температуре (при низких температурах это отношение возрастает), хотя расчетные значения этого параметра на порядок больше. Причина таких расхождений в пренебрежении эффектов рассеивания при расчетах. Эффекты рассеивания расширяют резо нанс, в то же время одновременно ослабляя его.
Для достижения высоких рабочих плотностей тока необходимо, чтобы барьеры были тонкими (несколько моноатомных слоев), а границы раздела - резкими, четкими. Однако экспериментально показано, что границы раздела не имеют химически резких, абсолютно плоских границ даже при оптимальных условиях формирования. Так, например, переход между GaAs и AlAs в наиболее перспективных для практического применения сверхрешетках на их основе происходит в пределах 1 - 4 монослоев. Поэтому потенциальный барьер на их границе не является строго ступенчатым, а размыт и зависит от рельефа поверхности границы. Это ведет к значительному уменьшению величины отношения токов в максимуме и минимуме области отрицательного дифференциального сопротивления на вольт-амперной характеристике диода и объясняет различие между теорией резонансного туннелирования и экспериментальными данными, что и проиллюстрировано рисунке 3.
Рисунок 3-Сравнение теоретических и экспериментальных данных для GaAs- AlAs резонансно-туннельного диода: а - плотность пикового тока;
б - отношение тока в максимуме к току в минимуме (PVR)
С точки зрения практического использования наиболее привлекательными характеристиками резонансно-туннельных диодов являются их чрезвычайно высокие скорости переключения. Обсуждая факторы, влияющие на быстродействие этих диодов, важно разделить два времени отклика: время на туннелирование, которое связано с квантовыми механизмами, и время, которое требуется для зарядки емкости диода и соотносится с теорией цепей.
где h - постоянная Планка, а Г0- ширина энергетического уровня, которая определяется как полуширина функции вероятности переноса электронов через резонансное состояние.
Г0 экспоненциально уменьшается с увеличением толщины и высоты барьера. Это означает, что для выбранных материалов уменьшение времени туннелиро- вания может быть получено путем уменьшения толщины барьера. Однако выбор оптимальной толщины требует учета зависимости отношения токов в максимуме и минимуме от этого параметра. Теоретический предел быстродействия идеального резонансно-туннельного диода оценивается в 0,1 пс. В реальных приборах неровности границ и неупругое рассеивание увеличивают время туннелирования.
В большинстве применений быстродействие резонансно-туннельных диодов ограничивается не только временем туннелирования, но и временем заряда емкости, то есть постоянной RSC(V). Это хорошо видно из эквивалентной схемы, приведенной на рисунке 2 б.
При обсуждении преимуществ резонансно-туннель ных диодов заслуживает внимания их сравнение с диодами Есаки (туннельными диодами). Диоды Есаки состоят из сильно легированного р-п перехода и имеют подобные вольт- амперные характеристики. Одно из наиболее важных преимуществ резонанс- но-туннельных диодов - это возможность получить высокую плотность максимального тока при относительно низкой емкости. Так, для резонансно-туннельных диодов достигнута экстремально высокая плотность тока 6,8 х 10 5 А/см 2 при емкости около 1,5 х 10 -7 . Эти величины указывают на то, что показатель скорости, который определяется как отношение удельной емкости к пиковой плотности тока C/Jp, меньше чем 0,22 пс/В. Показатель скорости соответствует скорости изменения напряжения, когда емкость диода заряжается его максимальным током. Эта величина намного меньше, чем для диодов Есаки, которая для последних больше чем 10 пс/В. Возможность такого различия связана с тем, что плотность тока в резонансно-туннельных диодах можно увеличить изменением толщины барьера и ямы, а это может быть достигнуто без уменьшения толщины обедненного слоя. С другой стороны, для того чтобы увеличить плотность тока в диодах Есаки, должна быть увеличена концентрация примеси для увеличения толщины туннельного барьера (равно как и обедненного слоя). Следовательно, максимальное быстродействие резонанс- но-туннельных диодов может быть намного больше, чем у диодов Есаки. Более того, в резонансно-туннельных диодах можно избежать деградации, наблюдаемой в диодах Есаки из-за диффузионного перераспределения примесей вблизи сильнолегированного p-n- перехода.
2.2 Транзисторы на резонансном тун нелировании
Добавление управляющего электрода к резонансно-туннель ному диоду превращает его в резонансно-туннельный транзистор (resonant tunneling transistor) и расширяет возможности его применения.В электрических схемах резонансно-туннельные транзисторы обозначают значком, представленным на рисунке 4. Потенциал, подаваемый на дополнительный электрод, смещает вольт-амперную характеристику диода вдоль оси тока (рисунок 2 б).
Рисунок 4-Условное обозначение резонансно-туннельного транзистора в электрических схемах
Можно также объединить резонансно-туннельный диод с обычным транзистором, чтобы сделать комбинированный прибор. Этот вариант использован для создания резонансно-туннельного биполярного транзистора (resonant tunneling bipolar transistor) и резонансно-туннельного транзистора на горячих электронах (resonant tunneling hot electron transistor).
Резонансно-туннельный биполярный транзистор представляет собой биполярный транзистор с резонансно-туннельной структурой, встроенной в области перехода эмиттер-база или в базе. Похож на него и резонансно-туннельный транзистор на горячих электронах, у которого резонансно-туннельная структура встраивается в эмиттер. Эти приборы имеют отрицательную крутизну характеристики в схеме включения с заземленным эмиттером. Кроме названных приборов имеются и транзисторные структуры, представляющие собой управляемые затвором резонансно-туннельные диоды (gated resonant tunneling diodes). Затворы в них создают в виде барьеров Шоттки или р-n-переходов вокруг эмиттера для внешнего управления условиями резонанса тока в диоде. На рисунке 5. показан пример такого прибора. В нем область эмиттера, а следовательно, и эмиттерный ток, можно модулировать с помощью потенциала на затворе, выполненного в виде p-n-перехода, окружающего эмиттер.
Рисунок 5-Управляемый затвором резонансно-туннельный диод на основе GaAs-AlAs
Такое управление эмиттерным током позволяет управлять максимальным током, протекающим через структуру в резонансных условиях.
2.3 Логические элементы на резонан сно-туннельных приборах
Резонансно-туннельные диоды и транзисторы применяются как в аналоговых, так и в цифровых интегральных микросхемах как элементы, имеющие вольт-амперную характеристику с участком отрицательного дифференциального сопротивления. Однако мы в качестве примера остановимся только на принципах построения оригинальных сверхбыстродействующих логических вентилей, использующих переход из моностабильного в бистабильное состояние (monostable-bistable transition logic elements - MOBILEs).
Когда область, в которую или из которой может происходить туннельный переход электрона, является квантово-размерной (квантовая плоскость, квантовая линия, квантовая точка), то наблюдается еще один интересный эффект – "резонансное туннелирование". Чтобы объяснить его физическую сущность, рассмотрим снова двойной туннельный барьер (ДТБ), в котором промежуточный слой между двумя туннельными переходами является квантовой плоскостью. На рис. 3.8 слева показаны соответствующие энергетические диаграммы. Вдоль вертикали отложена энергия электронов, вдоль горизонтали – координата. Цифрами 1 и 5 на последней обозначены внешние области, к которым прикладывается напряжение: 1 – катод, 5 – анод; и – энергетические уровни Ферми в них. Цифрами 2 и 4 обозначены туннельные барьеры, цифрой 3 – квантово-размерная область.
Как мы уже отмечали выше, в такой области значения энергии электрона квантованы. Через и обозначены разрешенные в этой области энергетические уровни. В диапазоне энергий, который здесь рассматривается, в этих областях нет разрешенных энергетических уровней для электронов.
Обозначим разности между разрешенными в квантово-размерной области энергетическими уровнями и и энергетическим уровнем Ферми через

Напомним, что при туннельном переходе энергия электрона не изменяется. Примем во внимание также то, что электрическое напряжение , приложенное между анодом и катодом, падает в основном на туннельных барьерах 2 и 4 и распределяется между ними примерно поровну. Потенциальная энергия электронов в области анода 5 уменьшается на величину , вследствие чего все энергетические уровни смещаются вниз. В квантово-размерной области 3 потенциальная энергия электронов уменьшается на величину , и на такую же величину смещаются вниз разрешенные энергетические уровни и .
Верхняя энергетическая диаграмма ( рис. 3.8.а) соответствует случаю, когда . Для большинства электронов из области 1, которые находятся вблизи уровня Ферми , в области 3 не находится разрешенного энергетического уровня. И потому их туннельный переход сквозь барьер 2 не происходит. Пройти сквозь этот барьер из области 1 могут лишь электроны с энергией на выше уровня Ферми, а таких электронов мало. Туннельный ток незначителен.
Когда же напряжение между анодом 5 и катодом 1 возрастает до величины, при которой , тогда уже значительная часть электронов с энергиями близ уровня Ферми имеет возможность пройти сквозь туннельный барьер 2. И электрический ток сквозь структуру резко возрастает, достигая максимума при . Типичная вольтамперная характеристика структуры показана на рис. 3.8.г. Когда напряжение превышает указанную величину, то для большинства электронов из области 1 снова не находится разрешенного энергетического уровня в области 3, и они не могут пройти в эту область. Туннельный ток сквозь структуру уменьшается ( рис. 3.8.в). И лишь когда напряжение начинает приближаться к величине , у некоторых электронов из области 1 появляется возможность перейти на разрешенный энергетический уровень . И тогда туннельный ток сквозь структуру снова начинает расти.
(примечение: я ничего не понимаю)
Описанное явление резкого возрастания электрического тока сквозь туннельный переход, когда энергетические уровни электронов с обеих сторон от перехода уравниваются, называют "резонансным туннелированием" (англ. resonant tunneling).
Решение квантовомеханической задачи прохождения электронов с энергией сквозь два барьера высотой и , разделенных расстоянием , шириной и , показанную на рис. 1, позволяет найти коэффициент прохождения .
| k2 |
| k3 |
| k1 |
| a3 |
| U2 |
| U1 |
| x |
| E |
| a1 |
| w1 |
| a2 |
| a4 |
| a5 |
| L |
| w2 |
Соответствующие уровни энергии называются резонансными уровнями квантовой ямы, разделяющей барьеры.
Соотношение для уровней изолированной ямы, когда система резонансных уровней практически не зависит от толщины барьера:
Резонансно-туннельный диод.


В общем случае резонансно-туннельный диод представляет собой периодическую структуру, которая состоит из последовательно расположенных квантовых колодцев, разделенных потенциальными барьерами, с электрическими контактами к двум крайним противоположным областям. Чаще всего это двухбарьерные структуры с одним квантовым колодцем и симметричными характеристиками барьеров, поскольку по мере увеличения количества колодцев все труднее реализовать условия для согласованного резонансного переноса носителей заряда.
Рис. 5 - Условное обозначение резонансно-туннельного диода (а), его эквивалентная схема (б), вольт-амперная и вольт-фарадная характеристики (в).
Емкость является чрезвычайно важной при определении быстродействия прибора. За исключением области напряжения вблизи токового резонанса она приблизительно равна емкости, рассчитанной для нелегированного разделительного слоя и обедненного слоя прибора. Пик емкости в области отрицательного дифференциального сопротивления обусловлен резонансными электронами, накопленными в яме.
Основной особенностью резонансно-туннельных диодов является наличие на его вольт-амперной характеристике области отрицательного дифференциального сопротивления, которая является основой для большинства его практических применений. Наиболее важные электрические параметры: пиковое значение плотности тока (peak current density) и пиковое напряжение (peak voltage) – напряжение в области пика плотности тока, долинная плотность тока в минимуме (valley current density), отношение этих плотностей тока (peak-to-valley ratio).

Папиллярные узоры пальцев рук - маркер спортивных способностей: дерматоглифические признаки формируются на 3-5 месяце беременности, не изменяются в течение жизни.
Поперечные профили набережных и береговой полосы: На городских территориях берегоукрепление проектируют с учетом технических и экономических требований, но особое значение придают эстетическим.
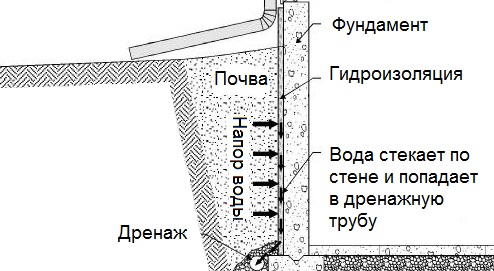
Общие условия выбора системы дренажа: Система дренажа выбирается в зависимости от характера защищаемого.

Туннельный диод — высокопроводящий, сильно легированный диод на базе p-n перехода, в котором ток индуцируется из-за туннелирования.
Туннельный диод представляет собой сильно легированный диод на базе p-n перехода. Концентрация примеси в обычном диоде составляет около 1 части на 108. А в туннельном диоде концентрация примеси составляет около 1 части на 103. Из-за сильного легирования полупроводник проводит ток, как в прямом направлении, так и в обратном направлении. Это быстрое переключающее устройство. Он используется в высокочастотных преобразователях, компьютерах и усилителях.
Обозначение туннельного диода на схеме
Обозначение туннельного диода на электрических схемах показано на рисунке ниже. Катод и анод являются двумя выводами из полупроводникового материала. Материал р-типа притягивает электроны, и поэтому он называется анодом, в то время как материал n-типа испускает электроны и называется катодом.

Конструкция туннельного диода
Туннельный диод имеет два вывода, а именно анод и катод. Полупроводник p-типа действует как анод, а полупроводниковый материал n-типа действует как катод. Для изготовления туннельного диода используются арсенид галлия, германий и антимонид галлия.

Отношение пикового значения прямого тока к значению тока в долине максимально в случае германия и минимально при использовании кремния. Следовательно, кремний не используется для изготовления туннельного диода. Плотность легирования туннельного диода в 1000 раз выше, чем у обычного диода.
Вольт-амперная характеристика туннельного диода
При прямом смещении туннельная проводимость наступает в диоде из-за их сильного легирования. Ток в диоде достиг своего максимального значения IP при подаче на него напряжения Vp. При дальнейшем увеличении напряжения ток через диод уменьшается. И он продолжает уменьшаться, пока не достигнет своего минимального значения. Это минимальное значение тока называется током впадины Iv.

Приведенный выше график показывает, что при переходе из точки А в точку В величина тока уменьшается с ростом напряжения. Итак, от A до B на графике показана область отрицательного сопротивления туннельного диода. Данная область показывает наиболее важное свойство диода. Здесь, в показанной области, туннельный диод отдает энергию, а не поглощает ее.
Принцип работы туннельного диода
Когда туннельный диод находится в состоянии равновесия, или мы можем сказать, что на диод не подается напряжение, в этом случае зона проводимости полупроводникового материала n-типа перекрывается с валентной зоной материала p-типа. Энергетические уровни дырок и электронов на стороне p и n соответственно остаются одинаковыми.
Когда температура повышается, электроны переходят от зоны проводимости n-области к валентной зоне p-области. Аналогично дырки, переходят от валентной зоны р-области до зоны проводимости n-области. Естественно, для туннельного перехода электрона через барьер из одной области в другую необходимо, чтобы по другую сторону барьера (место куда переходит электрон) имелось свободное состояние. Нулевой ток протекает через диод в состоянии равновесия.

Когда небольшое напряжение подается на туннельный диод, величина которого меньше напряжения в области обеднения, тогда электроны не пересекают область обеднения, и через диод протекает нулевой ток. Немногие электроны из n-области зоны проводимости туннелируются в p-область валентной зоны. Из-за туннелирования электронов небольшой прямой ток течет через область обеднения.

Когда на туннельный диод подается полное напряжение, создается определенное количество электронов и дырок. Увеличение напряжения увеличивает перекрытие проводимости и валентной зоны. Уровни энергии валентной зоны n-стороны и зоны проводимости p-стороны равны. Таким образом, через туннельный диод протекает максимальный ток.

Когда прикладываемое напряжение еще больше увеличивается, валентная зона и зона проводимость туннельного диода слегка смещаются. Но зона проводимости области n-типа и валентная зона области p-типа все еще перекрываются. Небольшой ток течет через диод, и, таким образом, ток начинает уменьшаться.

Если напряжение на проводнике сильно увеличивается, то туннельный ток падает до нуля. В этом состоянии зона проводимости n-стороны и валентная зона р-стороны не перекрывают друг друга, и туннельный диод ведет себя как обычный диод с PN-переходом. Если величина напряжения больше, чем контактная разность потенциалов, через диод течет прямой ток.
Понятие отрицательного сопротивления в туннельном диоде?
На графике выше показано, что между точкой Iv и Ip ток начинает уменьшаться, когда на него подается напряжение. Эта область графика называется областью отрицательного сопротивления. Это самая важная характеристика туннельного диода. В этой области туннельный диод генерирует энергию, а не поглощает ее.
Эквивалентная схема туннельного диода показана на рисунке ниже. Rs представляет сопротивление выводных клемм туннельного диода и полупроводникового материала. Оно примерно равно 5 Ом. Ls — индуктивность выводных клемм, и она почти равна 0,5 нГн. Cd — это диффузионная емкость перехода, и ее величина лежит в диапазоне от 5 до 100 пФ.

Преимущества и недостатки туннельного диода
Туннельный диод имеет низкую стоимость. У него низкий уровень шума, а его изготовление также очень просто. Диод дает быстрый отклик, и он умеренный в работе. Туннельный диод работает на малой мощности.
Недостатком туннельного диода является то, что выходное напряжение диода не является стабильным. Это двух контактное устройство, но его входные и выходные цепи не изолированы друг от друга.
Применение туннельного диода
Туннельный диод может использоваться в качестве усилителя и генератора для обнаружения малых высокочастотных сигналов или в качестве коммутатора. Это высокочастотный компонент, потому что он очень быстро реагирует на изменение значения входного сигнала.
Туннельный диод не получил слишком широкого применения, так как это слаботочное устройство.
Читайте также:

